第一章 单元测试
1、单选题:
本征硅的费米能级位于:( )
选项:
A:
B: 略偏向
略偏向
C: 略偏向
略偏向
D:
答案: 【 略偏向
略偏向
】
2、单选题:
硼掺杂的硅中,下列说法正确的是:( )
选项:
A:空穴浓度大于电子浓度
B:电子浓度大于空穴浓度
C:硅的晶体结构将发生改变
D:与磷掺杂硅的导电类型一致
答案: 【空穴浓度大于电子浓度
】
3、多选题:
抑制离子注入工艺中沟道效应的方法有( )。
选项:
A:降低离子注入能量
B:衬底表面沉积非晶薄膜
C:升高衬底温度
D:倾斜衬底
答案: 【衬底表面沉积非晶薄膜
;升高衬底温度
;倾斜衬底
】
4、多选题:
制造单晶硅衬底的方法包括( )。
选项:
A:直拉法
B:外延生长法
C:区域熔融法
D:氧化还原法
答案: 【直拉法
;区域熔融法
】
5、判断题:
当硅中掺杂浓度越小时,费米能级越靠近Ei。( )
选项:
A:错
B:对
答案: 【对】
第二章 单元测试
1、多选题:
对于长沟道MOSFET器件,发生夹断后,下面说法中正确的是( )。
选项:
A:Vg继续增加,Id不会继续增大
B:沟道中漏极一侧的电位为0
C:
D:Vg≥Vd+Vth
答案: 【Vg继续增加,Id不会继续增大
;沟道中漏极一侧的电位为0
;Vg≥Vd+Vth
】
2、多选题:
沟道长度缩短有可能对MOSFET器件产生哪些影响( )。
选项:
A:阈值电压增大
B:器件的集成度增加
C:器件的漏极电流增大
D:器件的可靠性劣化
答案: 【器件的集成度增加
;器件的漏极电流增大
;器件的可靠性劣化
】
3、单选题:
有关MOSFET器件亚阈值摆幅(S)的说法错误的是( )
选项:
A:
B:温度升高,亚阈值摆幅增大
C:亚阈值摆幅的单位是mV
D:
答案: 【亚阈值摆幅的单位是mV
】
4、单选题:
有关MOSFET器件特征长度的说法正确的是( )
选项:
A:仅与器件的结构参数有关
B:沟道长度相等的器件,特征长度越小,DIBL越小
C:与器件的沟道长度呈正比
D:栅氧化层介电常数越厚,特征长度越小
答案: 【沟道长度相等的器件,特征长度越小,DIBL越小
】
5、判断题:
MOSFET器件的阈值电压实际上是栅极MOS电容强反型区的起点。( )
选项:
A:对
B:错
答案: 【对】
第三章 单元测试
1、多选题:
下面有关浸没式光刻技术的说法,正确的是( )
选项:
A:能够增大物镜的数值孔径
B:由台积电的工程师林本坚发明
C:在目镜和衬底间填充水
D:能够减小光的波长
答案:
2、多选题:
相移光刻技术中,使光产生相位差的方法包括:( )
选项:
A:在掩膜板上的透光区域中添加移相器
B:减小未沉积铬区域的石英板厚度
C:利用整面透光的石英板,改变局部区域的厚度
D:改变石英掩膜板的倾斜角
答案:
3、单选题:
根据瑞利判据得到的光刻分辨率极限,表达式为( )
选项:
A:
B:
C:
D:
答案:
4、单选题:
正光刻胶和负光刻胶中,光敏剂的作用分别是( )
选项:
A:交联催化剂,交联催化剂
B:交联催化剂,提供自由基
C:提供自由基,提供自由基
D:提供自由基,交联催化剂
答案:
5、判断题:
光刻是集成电路制造过程中总成本最高的工艺。( )
选项:
A:错
B:对
答案:
第四章 单元测试
1、多选题:
有关半导体中载流子有效质量的说法正确的是( )
选项:
A:受到半导体晶格周期性势场的影响
B:与载流子的惯性质量在数值上相等
C:具有一定的概率分布
D:电子和空穴可能具有不同的有效质量
答案:
2、多选题:
张应变和压应变影响硅沟道中载流子迁移率的共同原因有( )
选项:
A:减小载流子有效质量
B:减小MOS界面粗糙度
C:增加能级分裂,抑制能谷散射
D:抑制界面态的库伦散射作用
答案:
3、单选题:
在硅沟道场效应晶体管器件中,埋入式源漏技术能够产生何种应变( )
选项:
A:既有可能产生张应变,又有可能产生压应变
B:其余选项说法都不对
C:仅能产生压应变
D:仅能产生张应变
答案:
4、单选题:
对于高集成密度的n型沟道的Si FinFET器件,合适的产生应变的技术是( )
选项:
A:应力记忆技术
B:SiGe虚拟衬底技术
C:SiGe埋入式源漏技术
D:接触式刻蚀中止层技术
答案:
5、判断题:
应变硅技术从90纳米技术节点开始进入量产。( )
选项:
A:对
B:错
答案:
第五章 单元测试
1、多选题:
有关High-k/metal gate技术的说法正确的是( )
选项:
A:能够减小栅氧化层中的电场强度
B:栅氧化层k值越大越好
C:能够提升沟道中的载流子迁移率
D:从45纳米技术节点开始进入量产
答案:
2、多选题:
作为High-k栅氧化层的材料,需要具备下面哪些特点( )
选项:
A:需要是常见材料
B:需要具有较高的k值
C:需要具有合适的能带结构
D:需要具有较好的稳定性
答案:
3、多选题:
下面哪种方法能够减小Si栅极堆垛的EOT( )
选项:
A:利用high-k材料替代二氧化硅栅绝缘层
B:减薄栅绝缘层的厚度
C:应用Scavenging技术
D:利用金属栅替代多晶硅栅
答案:
4、判断题:
几种薄膜沉积方法中,三维表面包覆能力由强到弱依次为:ALD、PECVD、电子束蒸镀。( )
选项:
A:对
B:错
答案:
5、判断题:
Scavenging技术实质上是氧化还原反应。( )
选项:
A:对
B:错
答案:
第六章 单元测试
1、多选题:
根据传输线模型,有关场效应晶体管器件源漏接触电阻的说法正确的是( )
选项:
A:源漏接触电极越大,接触电阻一定越小
B:分为长接触极限和短接触极限两种特例
C:源漏接触金属下方的电流密度不均匀
D:与金属的功函数无关
答案:
2、多选题:
当互联的最小特征尺寸减小时,下面说法错误的是( )
选项:
A:互联延时增大
B:互联延时减小
C:互联寄生电容不变
D:互联寄生电阻增大
答案:
3、单选题:
Al互联中不包含下面那个结构( )
选项:
A:Liner
B:Al配线
C:W通孔
D:Cu通孔
答案:
4、单选题:
下面哪种方法不能抑制场效应晶体管器件中的寄生电容( )
选项:
A:空气侧墙
B:后栅工艺
C:high-k栅绝缘层
D:引入沟道应变
答案:
5、判断题:
特征尺寸越小,栅极延迟和互联延时都越小。( )
选项:
A:错
B:对
答案:


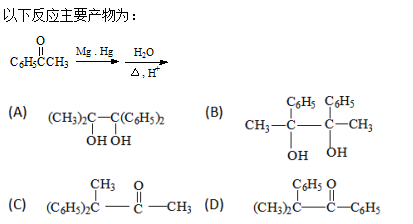
评论0